AppliedĪóEUVż╬Øó╦Īż“╚ŠžōżĄż╗żļźčź┐Ī╝ź¾źĘź¦źżźįź¾ź░äóÅøż“│½╚»
āS─╣13.5nmż╬EUVĪ╩Extreme Ultra VioletĪ╦źĻźĮź░źķźšźŻżŪżŌź└źųźļźčź┐Ī╝ź╦ź¾ź░ż¼Ų│Ų■żĄżņ╗Žżßż┐ĪŻż┐ż└żĘĪó▓“ćĄ┼┘ż¼30nmż▐żŪżĘż½įużķżņż╩żżż┐żßĪó░╠Åø╣ńż’ż╗ż¼žMżĘżżĪŻApplied MaterialsżŽĪó║ŪŠ«ż╬źčź┐Ī╝ź¾╔²ż“ŖW─Ļż╦Ę┴└«ż╣żļźčź┐Ī╝ź¾źĘź¦źżźįź¾ź░Č\Įčż“Ų│Ų■ż╣żļäóÅøĪųCentura SculptaĪūż“│½╚»żĘż┐ĪŻż│żņż“╗╚ż©żąź└źųźļźčź┐Ī╝ź╦ź¾ź░ż╚Ų▒┼∙ż╩Øó╦Īż“ŖW─Ļż╦Ę┴└«żŪżŁżļĪŻ

┐▐1ĪĪEUVż╬ź└źųźļźčź┐Ī╝ź╦ź¾ź░ż╚┼∙▓┴┼¬ż╦Ų▒żĖØó╦Īż“╝┬ĖĮż╣żļźčź┐Ī╝ź¾źĘź¦źżźįź¾ź░äóÅøĪĪĮąųZĪ¦Applied Materials
ĖĮ║▀ĪóźĒźĖź├ź»źūźĒź╗ź╣ż╬źšźĪź”ź¾ź╔źĻż╩ż╔ż¼5nmĪó3nmźūźĒź╗ź╣ź╬Ī╝ź╔ż╚╝ń─źżĘżŲżżżļż¼ĪóŪ█└■╔²/Ū█└■┤ų│ųż╬╝┬Øó╦ĪżŽ30nmźįź├ź┴ż¼║ŪżŌ╚∙║┘ż└ż╚żżż”ĪŻź└źųźļźčź┐Ī╝ź╦ź¾ź░żŽżĮż╬źįź├ź┴ż“╚Š╩¼µć┼┘ż╦╚∙║┘▓Įż╣żļż┐żßż╬Č\ĮčżŪżóżļĪŻżĘż½żĘĪó╚∙║┘ż╩Ū█└■ż╦ż╩żļż╚▐kż─ż╬öĄĖ■ż╦Ė■ż▒ż┐ź░źņĪ╝źŲźŻź¾ź░źčź┐Ī╝ź¾ż“╗\ż©żŲż»żļż¼ĪóŪ█└■ż╬├╝ż╚Ė■ż½żż╣ńż├ż┐Ū█└■ż╬├╝ż╬┤ųĪ╩tip to tipĪ╦ż╬▓“ćĄ┼┘żŽźčź┐Ī╝ź¾ż¼╩┬ż¾ż└öĄĖ■ż╬▓“ćĄ┼┘żĶżĻżŌØŁż║═Ņż┴żŲżĘż▐ż”Ī╩┐▐2Ī╦ĪŻ
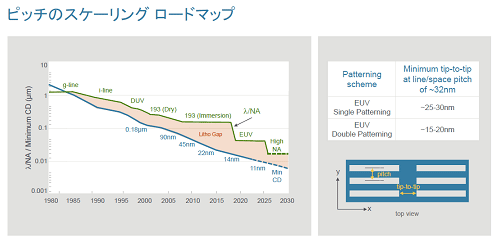
┐▐2ĪĪź░źņĪ╝źŲźŻź¾ź░źčź┐Ī╝ź¾ż╬YöĄĖ■żĶżĻ─Š│čż╬XöĄĖ■Ī╩źčź┐Ī╝ź¾ż╬├╝Ų▒╗╬ż╬š{▀`Ī╦ż╬▓“ćĄ┼┘ż╬öĄż¼─ŃżżĪĪĮąųZĪ¦Applied Materials
┐▐2ż╦żóżļ─╠żĻĪóĖĮėXż╬EUVż╬źĘź¾ź░źļźčź┐Ī╝ź╦ź¾ź░Č\ĮčĪóżĮż╬Ė■ż½żż╣ńż├ż┐źčź┐Ī╝ź¾ż╬├╝Ų▒╗╬ż╬┤ųżŽ25Ī┴30nmżĘż½Ę┴└«żŪżŁż╩żżĪŻź└źųźļźčź┐Ī╝ź╦ź¾ź░żŪĘ┴└«żŪżŁż┐ż╚żĘżŲżŌ15Ī┴20nm┘Vż▐żĻżŪżóżļĪŻź└źųźļźčź┐Ī╝ź╦ź¾ź░żŪżŽ░╠Åø╣ńż’ż╗ĖĒ║╣ż“Š«żĄż»ż╣żļż│ż╚ż¼žMżĘż»Īó╩Ōé╬ż▐żĻżŽČ╦żßżŲĄKż»ż╩żļĪŻ
żĮż│żŪĪóAppliedżŽ2övų`ż╬źčź┐Ī╝ź╦ź¾ź░ż╦źĻźĮź░źķźšźŻż“╗╚ż’ż║ż╦Īóźūźķź║ź▐ź©ź├ź┴ź¾ź░żŪźčź┐Ī╝ź¾ż“║’żļČ\Įčż“│½╚»żĘż┐ĪŻÉ║öü┼¬ż╦żŽEUVżŪ╬Ńż©żąźėźóź█Ī╝źļż╩ż╔ż╬źčź┐Ī╝ź¾ż“Ę┴└«żĘż┐ĖÕż╦ŖAżßöĄĖ■ż½żķźūźķź║ź▐źĻź▄ź¾źėĪ╝źÓżŪź”ź¦Ī╝źŽµ£ĀCż“ź╣źŁźŃź¾ż╣żļĪŻźūźķź║ź▐żŪ╚»Ö┌żĘż┐źżź¬ź¾ż╚├µ└ŁźķźĖź½źļż╬║«╣ńźėĪ╝źÓż“ŖAżßż½żķ┼÷żŲżļż│ż╚żŪŖõĀCż“║’ż├żŲżżż»ĪŻżĮżņżŌź”ź¦Ī╝źŽż“öv┼ŠżĄż╗Ė■żŁż“─┤┼DżĘżŲČč▐kż╦źčź┐Ī╝ź¾ż“║’żĻŲDż├żŲżżż»Ī╩┐▐3Ī╦ĪŻ
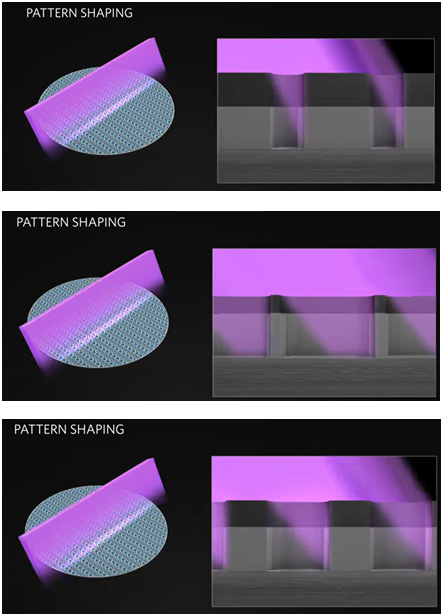
┐▐3ĪĪźūźķź║ź▐źėĪ╝źÓż“ŖAżßż½żķŠ╚╝oż╣żļż│ż╚żŪĪóźčź┐Ī╝ź¾ż╬Ŗõ╩╔ż“║’żĻźčź┐Ī╝ź¾ż“║┘ż»ż╣żļĪ╩æų┐▐ż½żķ▓╝┐▐żžĪ╦ĪĪĮąųZĪ¦Applied Materialsż╬źėźŪź¬
ż│ż╬öĄ╦ĪżŪżóżņżąĪóEUVźĻźĮź░źķźšźŻżŽ1övżŪ║čż▀Īó┼Ļ½@ź│ź╣ź╚żŽŖWż»ż╩żļż╚ż╚żŌż╦×æļ]ź│ź╣ź╚żŌŖWż»ż╩żļż╚żżż”ĪŻźčź┐Ī╝ź╦ź¾ź░żŽEUVż“╗╚ż”żĶżĻżŌį~├▒ż╦ż╩żļż┐żßż└ĪŻż│ż╬±T▓╠ĪóEUVäóÅøż╬Š├õJ┼┼╬üżŽż½ż╩żĻĮjżŁżżż┐żßĪó┼┼╬üż¬żĶżėżĮż╬ź│ź╣ź╚ż╬║’žōż╦ż─ż╩ż¼żĻCO2║’žōż╦żŌż╩żļĪŻ
źūźķź║ź▐źėĪ╝źÓżŪ║’żĻŲDżļż│ż╬öĄ╦ĪżŽĪóźėĪ╝źÓż╬Ė■żŁżõźėĪ╝źÓäė┼┘Ī╩źūźķź║ź▐╠®┼┘ż╩ż╔Ī╦Īó│č┼┘Īóź╣źŁźŃź¾Å]┼┘ż╩ż╔żŪöUĖµż╣żļĪŻź©ź├ź┴ź¾ź░ż“╗■┤ųżŪöUĖµż╣żļ▄ćŪ░ż╦ō¶żŲżżżļĪŻApplied MaterialsżŽĪóEUVź└źųźļźčź┐Ī╝ź╦ź¾ź░ż╦ż╚ż├żŲ┬Õż’żļČ\Įčż╦ż╩żĻż”żļż╚┤³┬įżĘżŲżżżļĪŻ


